글 | 토마스 어만, 비오렐 드레고이, 제럴드 미튼도르퍼, EV Group 토우스텐 호이저, 크리스티안 바우어, TDK Epcos

스마트폰 시장의 주도로 모바일 통신 분야는 빠르게 성장했다. 스마트폰의 핵심 부품 중 하나인 SAW 필터는 기계적인 파동을 압전기 기질의 표면으로 전달한다. 웨이브(Wave)를 효과적으로 전달하기 위해 차세대 캐비티(cavity)를 적용하는 것이 SAW 필터 생산공정에서 매우 중요하다. 최첨단 패키징 기술, 특히 정렬된 접착식 웨이퍼 본딩(Aligned Wafer bonding) 기술은 다이 사이즈 폼 팩터로 SAW 패키지를 만드는 기술을 가능하게 했다.
서론
SAW 필터는 쿼츠 크리스털(Quartz crystal)과 LC 필터, 웨이브가이드 필터(Waveguide Filter) 같은 다른 필터 기술보다 우수한 필터 기능과 작은 사이즈로 모바일 통신에서 최고의 제품으로 입지를 다지고 있다. 특히 SAW 필터 사이즈가 작아지면서 휴대폰은 더 소형화되고 수신 성능과 대역 성능을 높일 수 있게 됐다.
필터의 전체 사이즈를 줄이는 데 일등 공신은 패키징이다. 최근 몇 년간 CSSP(Chip Size SAW Package)가 SAW 패키징 기술의 대세를 이루었다. 이 기술의 경우 면적은 멀티레이어 세라믹에 크게 좌우된다. 그 후 칩 사이즈만큼 작은 패키지를 구현할 수 있는 새로운 DSSP(Die Sized SAW Package) 기술이 탄생했다. 그림 1은 지난 10년간 제조된 단일 SAW 필터의 패키지 사이즈가 어떻게 발전해 왔는지를 보여 준다. 평평한 디바이스 아키텍처는 DSSP 제품의 주요한 특징 중 하나다. 예를 들어 높이가 0.22 mm 미만인 단일 SAW 디바이스도 구현됐다[1].
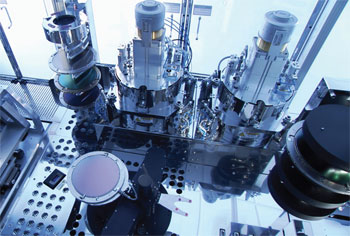
DSSP 기술은 디바이스 소형화와 성형 압력 내성 등이 중요한 성능 지표가 되는 RF(무선 주파수) 모듈에 가장 적합하다. RF 모듈의 경우, 디바이스들은 표면 실장 기술을 사용해 조립되고, 일반적으로 이송 성형 방식(transfer molding )으로 방식층(outer sheath )이 형성된다. DSSP 디바이스는 최고 100 mbar의 압력으로 성형할 수 있어 RF 모듈 응용 분야에 한층 발전된 솔루션을 제공한다.
SAW 패키지 제조 공정은 여러 가지 면에서 MEMS(마이크로 전자 기계 시스템)와 비슷하다. 특히 올바른 표면 파동 전달을 위한 캐비티의 생성 방식이 유사하다. 이러한 캐비티 패키지 유형은 기능성 압전기 기질 위에 폴리머 프레임을 포토리소그래피 방식으로 패터닝하는 기술과 접착식 웨이퍼 본딩 기술을 사용하여 실현된다.
SAW 제조 공정
모든 SAW 디바이스는 LiTaO3 또는 LiNbO3로 만든 기능성 압전기 웨이퍼를 기반으로 한다. 이 웨이퍼는 표면 파동의 자기화, 전달 및 검출할 수 있는 기계적 특성을 가졌다. 알루미늄 또는 구리 재질로 깍지 낀 손가락과 같은 구조를 한 소위 트랜스듀서와 필터의 측면 치수가 SAW 디바이스의 대역 통과 필터 특성을 결정한다. 후속 공정 단계에서는 영구 접착층이 프레임과 바에 코팅되고 패터닝된다. 이러한 바는 성형 공정이 진행되는 동안 패키지가 고온과 고압의 환경에서 붕괴하지 않도록 패키지 내부의 기계적 응력을 줄인다. 프레임과 바로 이뤄진 구조는 기능성 웨이퍼(functional wafer)를 본딩 전에 미리 제작된 캡 웨이퍼에 본딩하는 후속 공정을 위한 접착증 역할도 한다(그림 2).
모든 재료에는 CTE(열 팽창 계수)가 있다. CTE는 온도의 변화에 따라 물체의 크기가 어떻게 변화하는지를 측정한 값이다. 최적의 패키징 신뢰도와 웨이퍼 본딩 수율을 보장하려면 기능성 웨이퍼와 캡 웨이퍼(그림 3)의 CTE가 매우 유사하거나 일치해야 한다. 이 특수한 DSSP 패키지에서 두 웨이퍼는 같은 재질로 제작된다. 캡 웨이퍼는 웨이퍼 레벨 그라인딩 후 싱귤레이션(Singulation)을 한다.

접착식 웨이퍼 본딩
웨이퍼 본딩은 EV Group(EVG)의 GEMINI짋 자동화 웨이퍼 본딩 시스템(그림 4)을 사용해 이뤄진다. 다양한 웨이퍼 본딩 형태가 있지만, 접착식 본딩 기술은 DSSP 제조에 있어 이점이 많다. 몇 가지 이점을 소개하면 저온 처리(400 °C 미만의 최고 온도), 표면 평탄화, 입자 오염에 대한 내성(중간층에서 층 두께 범위 이내의 직경을 가진 입자를 수용할 수 있음) 등이다[2, 3].
기능성 웨이퍼와 캡 웨이퍼는 모두 본딩 전에 얼라인(Align)해야 한다. 이 공정에는 EVG SmartView 자동 본딩 얼라인(Align) 시스템이 사용된다. 1985년, EVG는 세계 최초로 양면 얼라인 시스템을 개발하면서 MEMS 제조 공정에 일대 혁신을 가져왔고 얼라인 공정과 본딩 공정을 분리함으로써 얼라인된 웨이퍼 본딩 기술의 새로운 세계 표준으로 제시했다.
분리된 공정 덕분에 공정의 유연성이 높아졌고 웨이퍼 본딩 장비를 범용으로 활용할 수 있게 됐다. 다른 얼라인 원리는 한쪽 웨이퍼의 투명도나 캐비티에 의존하지만, SmartView의 경우 표준 포토리소그래피 정렬 마크를 사용한 Face-to-Face Align이 가능하다. 또한 모듈식 얼라이너 설계를 채택해 정렬 성능이 서로 다른 Eutectic, Adhesive 또는 Fusion 웨이퍼 본딩과 같은 다양한 플랫폼에 내장할 수 있다.
넓은 적용 면과 설계에서는 주 본딩층에 다음과 같은 특성이 요구된다.
-- 등방성 유전율
-- 우수한 내열성
-- 낮은 영률(Young’s modulus)
-- 다양한 기질에 대한 우수한 접착력
웨이퍼 본딩 공정에서 본딩 용제나 접착제로 사용되는 폴리머 재질은 본딩 중 나타나는 작용 방식에 따라 크게 두 가지로 분류된다. 그중 하나는 본딩 공정 중에 점성을 띄면서 흐르는 재질이고 다른 하나는 베이킹 공정과 이후 본딩 공정 중에도 강성을 유지한다. 이 두 가지 작용 방식은 공정 결과에 영향을 미쳐 웨이퍼 본딩에 매우 중요하다. 유동적인 폴리머는 높은 토포그래피(topography)에서 표면의 평탄화 성능이 매우 우수한 이점이 있지만, 재료 압착으로 인한 공구 오염, 본딩층 압착과 높은 기질 이동 가능성에 인한 낮은 웨이퍼 간 정렬 정확도 등 몇 가지 중대한 단점이 있다.
강성 폴리머는 웨이퍼 간 얼라인 정확도가 높고 두 기질 간의 정해진 간격이 유지되며 포토리소그래피만으로 본딩층의 패턴을 정의(스페이서, 채널 등)할 수 있다는 점에서 이점이 있다. 폴리머 영률도 열팽창 계수가 서로 다른 기질을 본딩할 때 매우 중요한 특성으로 작용한다. 이러한 응용 분야에서는 영률이 낮은 폴리머를 사용하면 본딩 고정에서 발생한 열적 유도 응력을 상당량 흡수할 수 있어 본딩된 기질의 휨 현상을 줄일 수 있다.

폴리머 재질이 가열되면 처음에는 열로 인한 중합(polymerization) 반응 때문에 점도가 상승한다. 하지만 특정 온도에 도달하고 나면 두 번째 중합 반응 메커니즘이 시작될 때까지 점도가 낮아진다. 계속 가열하면 폴리머의 광활성 성분이 분해되면서 산이 생성된다. 생성된 산은 두 번째 중합 반응 과정을 유도해 다시 점도를 높인다.
점도가 낮은 온도 범위에서 캡 웨이퍼 접착제의 습윤 성능이 가장 우수하게 나타나 이 범위의 본딩력을 적용해야 한다. 본딩 후에 최종 중합 반응 단계를 거쳐야 하는 폴리머가 많다. 이렇게 하면 용제 함량과 흡수율이 낮은 고도로 상호 본딩된 폴리머를 얻을 수 있다.
SAW DSSP 패키지의 경우 다른 변수도 몇 가지 고려해야 한다. 예를 들어 압전기 기질의 표면 에너지는 실리콘과 다르므로 폴리머 재질의 습윤 및 접착 특성도 달라질 수 있다. 또한 접착제는 포토리소그래피를 사용하여 패터닝할 수 있는 영구 저항이어야 한다. 기능성 웨이퍼와 캡 웨이퍼의 TTV를 균일화하려면 포토리소그래피 이후 재질의 최종 두께도 10 μm 이상이어야 한다. 최종 중합 반응 후 저항의 흡수율도 무시할 수 있는 수준이어야 한다. 그뿐만 아니라 정의된 안정성 테스트 조건에서 부식을 방지하려면 재료의 할로겐화물 함량이 몇 ppm 이내여야 한다.
요약
접착식 웨이퍼 본딩 기술은 칩 사이즈 SAW 패키지에 사용되는 핵심 기술 중 하나다. 이 기술의 주요한 이점은 프레임의 단순한 포토리소그래피 패터닝 방식과 캐비티 형성을 위한 지지 구조를 들 수 있다. 이 방식에서는 기질의 면적 효율성을 높이기 위해 접착제의 패터닝 해상도가 요구된다. 패터닝 이후의 초기 경화 작용은 높은 정렬 정확도와 손쉬운 웨이퍼 취급을 가능하게 한다. 중합(polymeric) 본딩 접착제의 복잡한 점성은 양쪽 강성 웨이퍼 표면에서 우수한 습윤 성능을 제공한다. 또한 본딩 공정에서 폴리머의 적응성과 본딩 챔버의 고도로 균일화된 압력 및 온도는 일정한 재료 리플로와 높은 패키지 수율을 보장한다.

<저작권자(c)스마트앤컴퍼니. 무단전재-재배포금지>