자이스 "복잡한 패키지 불량, 고해상 3D 엑스레이로 잡아내"
2019-01-26 신윤오 기자, yoshin@elec4.co.kr
첨단 반도체 패키징 불량분석(FA)용 이미징 솔루션 라인업 확대
광학 기업의 대명사, 자이스(ZEISS)가 복잡한 패키지의 불량 검사를 위한 엑스레이 이미징 솔루션 라인업을 확장했다. 사실상의 업계 표준 장비로 불리는 기존 엑스레디아 500 시리즈 버사 XRM의 후속 제품들이 다양한 포트폴리오를 갖춘 셈이다.
이들 고해상 3D 엑스레이 이미징 솔루션 최신 제품은 2.5/3D 및 팬아웃 웨이퍼 레벨 패키지(FoWLP) 등 첨단 반도체 패키지의 불량분석(failure analysis, FA)이 가능하다.
이번에 새로 선보이는 장비는 각각 서브마이크론과 나노급 패키지 FA 작업에 사용되는 엑스레디아 600 시리즈 버사(Xradia 600-series Versa)와 엑스레디아 800 울트라 엑스레이 현미경(XRM), 그리고 새로운 엑스레디아 콘텍스트 마이크로CT(Xradia Context microCT) 등이다. 회사 측은 최신 장비 출시를 두고 “이제 반도체 산업을 위한 가장 방대한 3D 엑스레이 이미징 기술 포트폴리오를 제공하게 됐다”고 평했다.
복잡해지는 패키지 구조를 따라가라
이처럼 고해상 3D 엑스레이 이미징이 필요한 이유는 한계에 다다른 반도체의 미세 공정이 있다. CMOS 공정 축소 노드가 한계선에 가까워지면서, 반도체 성능 간극을 메우는데 도움이 되는 패키징 기술이 필요해졌기 때문이다.
이에 반도체 업계에서는 칩을 3D로 적층하는 방식이나 그 밖에 다른 혁신적인 방식의 패키징 기법으로 전환하는 추세다. 이는 패키지 구조를 점점 더 복잡하게 만들고 제조상의 새로운 과제들을 배출할 뿐 아니라 패키지 불량의 가능성도 높인다. 특히 불량이 발생하는 물리적 위치가 복잡한 3D 구조 안에 묻혀 있는 경우도 많기 때문에, 불량의 위치를 시각화하기 위한 고해상 3D 엑스레이 이미징이 필요하게 됐다.

롤리 에스트라다(Raleigh Estrada) 자이스 SMT 선임 마케팅 디렉터는 “앞으로 패키지 기술은 칩간 인터커넥트 밀도는 높이고 칩간 거리는 좁힘으로써 실질적인 성능 향상에 기여할 것을 주문하고 있다”며, “미래 첨단 패키지는 고밀도 3D 구조를 사용함으로써 복잡도가 엄청나게 높아질 것으로 예상한다”고 말했다.
자이스의 새로운 3D 엑스레이 이미징 솔루션은 첨단 3D 패키지의 온전한 구조 안에 담겨 있는 기능과 결함을 서브마이크론 및 나노급 3D 이미지로 보여줄 수 있다. 샘플을 회전하여 서로 다른 각도의 다양한 2D 엑스레이 이미지들을 캡처한 다음, 정교한 수학적 모델과 알고리즘을 사용하여 3D 입체 모양을 재구성하는 원리를 이용했다. 회사 측은 자이스의 새로운 서브마이크론 및 나노급 XRM 솔루션을 조합해 사용하면, 자이스 특유의 FA 작업 흐름을 통해 FA 성공률을 크게 높일 수 있다고 강조한다. 자이스의 새로운 엑스레디아 콘텍스트 마이크로CT는 프로젝션 기반의 기하학적 확대 기술을 활용하여 넓은 시야각에서 높은 콘트라스트와 해상도를 제공한다. 또한 엑스레디아 버사로 완벽하게 업그레이드가 가능하다.
새로운 라인업, 어떤 특징 장착했나
엑스레디아 600 시리즈 버사는 온전한 반도체 패키지 내부의 국부적인 결함을 비파괴 방식으로 시각화하기 위한 차세대 3D XRM 장비이다. 이 제품은 공정 개발, 수율 개선, 구조 분석을 위한 구조적 및 FA 애플리케이션에서 탁월한 성능을 나타내며 RaaD(Resolution at a Distance) 기능을 지원하고 수상 실적도 갖고 있는 버사 플랫폼을 기반으로 설계됐다.
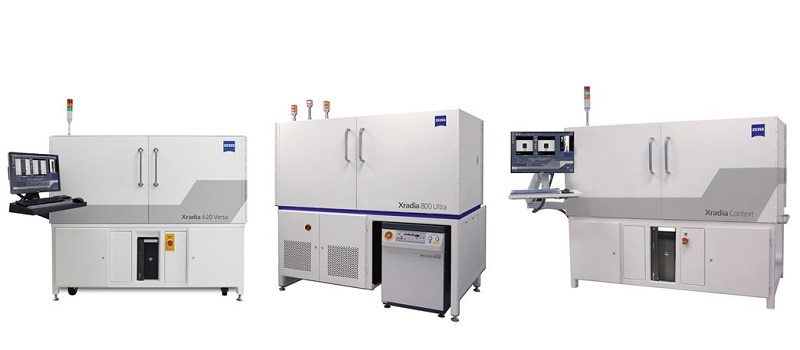
새로운 엑스레디아 600 시리즈 버사는 패키지와 PCB, 300mm 웨이퍼의 결함과 불량의 근본적 원인을 확인할 수 있도록 원거리에서 대형 샘플에 대한 고해상 이미징을 표시한다. 이 장비는 일반적인 범프나 마이크로범프의 균열이나 솔더 웨팅 (solder wetting) 문제, 또는 TSV(Through Silicon Via) 보이드 같은 패키지 레벨의 불량과 관련된 결함을 눈으로 쉽게 확인할 수 있게 해준다. PFA(Physical Failure Analysis)를 시도하기 전에, 이처럼 결함을 3D로 시각화하면 인공결함(artifact)을 줄이고 단면 방향을 지정할 수 있어, 궁극적으로 FA 성공률을 높일 수 있다.
또 하나의 신제품, 엑스레디아 800 울트라는 나노급 영역에 대한 3D XRM을 지원함으로써, 패키지에 묻힌 기능들의 이미지를 나노 크기의 공간 분해능으로 생성하면서, 확인하고자 하는 영역의 볼륨 무결성을 보존한다. 이 장비는 초미세 피치의 플립칩 및 범프 연결의 공정 분석, 구조 분석, 결함 분석에 활용되어 초미세 피치 패키지와 BEOL(back-end-of-line)의 공정을 향상시킬 수 있다.

라즈 자미(Raj Jammy) 자이스 공정제어솔루션(PCS) 및 칼 자이스 SMT 사장
엑스레디아 800 울트라는 미세피치 코퍼 필라 마이크로범프(copper pillar microbump) 안의 금속간 화합물이 소비하는 솔더의 텍스처와 부피를 시각화 할 수도 있다. 시각화 하는 동안 결함 부분은 그대로 보존되기 때문에, 다양한 기법들을 동원한 후속 분석이 가능하다. 웨이퍼-대-웨이퍼 본딩 인터커넥트나 다이렉트 하이브리드 본딩 같은 블라인드 어셈블리의 구조 품질도 3D로 특성화 할 수 있다.
마지막으로 새로운 엑스레디아 콘텍스트 마이크로CT는 버사 플랫폼을 기반으로 한 새로운 서브마이크론 분해능 3D 엑스레이 마이크로CT 시스템이다. 신제품은 근거리에서 고효율로 패키지에 대한 고해상 이미징 검사를 수행할 수 있도록 설계됐다.
자이스 공정제어솔루션(PCS) 및 칼 자이스 SMT(Carl Zeiss SMT)의 사장인 라즈 자미(Raj Jammy) 박사(Ph.D.)는 “2D 엑스레이 및 기계적 단면 절단 같은 기존의 구조 분석 및 불량 분석 기법은 오늘날의 고밀도 3D 패키지 설계에는 부적합하다”며, “이러한 요건들을 충족하기 위해 자이스는 패키징용 엑스레이 솔루션 포트폴리오를 확장할 것”이라고 밝혔다.
광학 기업의 대명사, 자이스(ZEISS)가 복잡한 패키지의 불량 검사를 위한 엑스레이 이미징 솔루션 라인업을 확장했다. 사실상의 업계 표준 장비로 불리는 기존 엑스레디아 500 시리즈 버사 XRM의 후속 제품들이 다양한 포트폴리오를 갖춘 셈이다.
이들 고해상 3D 엑스레이 이미징 솔루션 최신 제품은 2.5/3D 및 팬아웃 웨이퍼 레벨 패키지(FoWLP) 등 첨단 반도체 패키지의 불량분석(failure analysis, FA)이 가능하다.
이번에 새로 선보이는 장비는 각각 서브마이크론과 나노급 패키지 FA 작업에 사용되는 엑스레디아 600 시리즈 버사(Xradia 600-series Versa)와 엑스레디아 800 울트라 엑스레이 현미경(XRM), 그리고 새로운 엑스레디아 콘텍스트 마이크로CT(Xradia Context microCT) 등이다. 회사 측은 최신 장비 출시를 두고 “이제 반도체 산업을 위한 가장 방대한 3D 엑스레이 이미징 기술 포트폴리오를 제공하게 됐다”고 평했다.
복잡해지는 패키지 구조를 따라가라
이처럼 고해상 3D 엑스레이 이미징이 필요한 이유는 한계에 다다른 반도체의 미세 공정이 있다. CMOS 공정 축소 노드가 한계선에 가까워지면서, 반도체 성능 간극을 메우는데 도움이 되는 패키징 기술이 필요해졌기 때문이다.
이에 반도체 업계에서는 칩을 3D로 적층하는 방식이나 그 밖에 다른 혁신적인 방식의 패키징 기법으로 전환하는 추세다. 이는 패키지 구조를 점점 더 복잡하게 만들고 제조상의 새로운 과제들을 배출할 뿐 아니라 패키지 불량의 가능성도 높인다. 특히 불량이 발생하는 물리적 위치가 복잡한 3D 구조 안에 묻혀 있는 경우도 많기 때문에, 불량의 위치를 시각화하기 위한 고해상 3D 엑스레이 이미징이 필요하게 됐다.

롤리 에스트라다(Raleigh Estrada) 자이스 SMT 선임 마케팅 디렉터
롤리 에스트라다(Raleigh Estrada) 자이스 SMT 선임 마케팅 디렉터는 “앞으로 패키지 기술은 칩간 인터커넥트 밀도는 높이고 칩간 거리는 좁힘으로써 실질적인 성능 향상에 기여할 것을 주문하고 있다”며, “미래 첨단 패키지는 고밀도 3D 구조를 사용함으로써 복잡도가 엄청나게 높아질 것으로 예상한다”고 말했다.
자이스의 새로운 3D 엑스레이 이미징 솔루션은 첨단 3D 패키지의 온전한 구조 안에 담겨 있는 기능과 결함을 서브마이크론 및 나노급 3D 이미지로 보여줄 수 있다. 샘플을 회전하여 서로 다른 각도의 다양한 2D 엑스레이 이미지들을 캡처한 다음, 정교한 수학적 모델과 알고리즘을 사용하여 3D 입체 모양을 재구성하는 원리를 이용했다. 회사 측은 자이스의 새로운 서브마이크론 및 나노급 XRM 솔루션을 조합해 사용하면, 자이스 특유의 FA 작업 흐름을 통해 FA 성공률을 크게 높일 수 있다고 강조한다. 자이스의 새로운 엑스레디아 콘텍스트 마이크로CT는 프로젝션 기반의 기하학적 확대 기술을 활용하여 넓은 시야각에서 높은 콘트라스트와 해상도를 제공한다. 또한 엑스레디아 버사로 완벽하게 업그레이드가 가능하다.
새로운 라인업, 어떤 특징 장착했나
엑스레디아 600 시리즈 버사는 온전한 반도체 패키지 내부의 국부적인 결함을 비파괴 방식으로 시각화하기 위한 차세대 3D XRM 장비이다. 이 제품은 공정 개발, 수율 개선, 구조 분석을 위한 구조적 및 FA 애플리케이션에서 탁월한 성능을 나타내며 RaaD(Resolution at a Distance) 기능을 지원하고 수상 실적도 갖고 있는 버사 플랫폼을 기반으로 설계됐다.
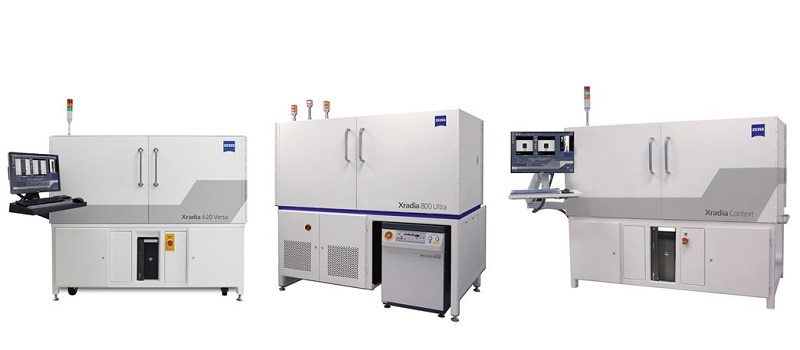
(왼쪽부터) 엑스레디아 600 시리즈 버사, 엑스레디아 800 울트라, 엑스레디아 콘텍스트 마이크로CT
새로운 엑스레디아 600 시리즈 버사는 패키지와 PCB, 300mm 웨이퍼의 결함과 불량의 근본적 원인을 확인할 수 있도록 원거리에서 대형 샘플에 대한 고해상 이미징을 표시한다. 이 장비는 일반적인 범프나 마이크로범프의 균열이나 솔더 웨팅 (solder wetting) 문제, 또는 TSV(Through Silicon Via) 보이드 같은 패키지 레벨의 불량과 관련된 결함을 눈으로 쉽게 확인할 수 있게 해준다. PFA(Physical Failure Analysis)를 시도하기 전에, 이처럼 결함을 3D로 시각화하면 인공결함(artifact)을 줄이고 단면 방향을 지정할 수 있어, 궁극적으로 FA 성공률을 높일 수 있다.
또 하나의 신제품, 엑스레디아 800 울트라는 나노급 영역에 대한 3D XRM을 지원함으로써, 패키지에 묻힌 기능들의 이미지를 나노 크기의 공간 분해능으로 생성하면서, 확인하고자 하는 영역의 볼륨 무결성을 보존한다. 이 장비는 초미세 피치의 플립칩 및 범프 연결의 공정 분석, 구조 분석, 결함 분석에 활용되어 초미세 피치 패키지와 BEOL(back-end-of-line)의 공정을 향상시킬 수 있다.

라즈 자미(Raj Jammy) 자이스 공정제어솔루션(PCS) 및 칼 자이스 SMT 사장
마지막으로 새로운 엑스레디아 콘텍스트 마이크로CT는 버사 플랫폼을 기반으로 한 새로운 서브마이크론 분해능 3D 엑스레이 마이크로CT 시스템이다. 신제품은 근거리에서 고효율로 패키지에 대한 고해상 이미징 검사를 수행할 수 있도록 설계됐다.
자이스 공정제어솔루션(PCS) 및 칼 자이스 SMT(Carl Zeiss SMT)의 사장인 라즈 자미(Raj Jammy) 박사(Ph.D.)는 “2D 엑스레이 및 기계적 단면 절단 같은 기존의 구조 분석 및 불량 분석 기법은 오늘날의 고밀도 3D 패키지 설계에는 부적합하다”며, “이러한 요건들을 충족하기 위해 자이스는 패키징용 엑스레이 솔루션 포트폴리오를 확장할 것”이라고 밝혔다.
<저작권자(c)스마트앤컴퍼니. 무단전재-재배포금지>
100자평 쓰기









